Description
Detailed Parameter Table
| Parameter Name | Parameter Value |
| Product Model | LAM 810-035270-004 |
| Manufacturer | LAM Research Corporation |
| Product Category | Vacuum Pump Control Module (Dual-Pump Synchronization) |
| Controlled Pump Types | Turbomolecular Pumps (TMP, e.g., Pfeiffer TPH 360), dry backing pumps (e.g., Pfeiffer DUO 35 M); supports up to 2 pumps per unit |
| Vacuum Control Range | 1×10⁻¹⁰ Torr (UHV) to 760 Torr (atmospheric); compatible with medium-to-UHV sensor input |
| Pump Speed Regulation | 0–100% RPM (analog 0–10 VDC output); Speed accuracy: ±0.8% of setpoint; Ramp rate adjustability (0.5–8% RPM/s) |
| Sensor Input Compatibility | Analog (4–20 mA, 0–10 VDC) for pressure sensors; Digital (RS-485) for LAM sensors (LAM 716-027740-001, LAM 716-028123-004); Supports 4 sensor channels |
| Control Interface | Ethernet (Modbus TCP); Digital: RS-485 (Modbus RTU); Native integration with LAM Process Control Software (PCS v5.5+) |
| Operating Voltage | 110–240 VAC (50/60 Hz); Power consumption: ≤150 W (max); Inrush current: ≤8 A (peak) |
| Operating Temperature Range | 15°C–55°C (59°F–131°F); Storage: -20°C–70°C (-4°F–158°F) |
| Environmental Ratings | IP54 (dust/water resistance); Cleanroom Compatibility: ISO Class 3 (per ISO 14644-1); Vibration Resistance: 4 g (10–2000 Hz) |
| Safety Features | Overcurrent protection (12 A); Over-temperature shutdown (≥60°C); Pump overload detection (current monitoring); Emergency stop (E-stop) integration; Short-circuit protection |
| Display & Alerts | 4.3” color touchscreen (real-time pump speed, pressure, error codes); Audible/visual alarms (high pressure, pump failure); Remote alert via LAM PCS |
| LAM Component Compatibility | Works with LAM 716-027740-001 (medium-vacuum sensor), LAM 716-028123-004 (UHV sensor), LAM 713-071681-009 (UHV valve); Syncs with LAM RFCM (RF Control Module) |
| Compatible LAM Systems | LAM 790 Series Plasma Etch (28nm–14nm), LAM 2300 Series Deposition (legacy ALD), LAM Coronus® Plasma Clean (mid-range vacuum) |
| Physical Dimensions | 19” rack-mount (2U height); 482.6 mm (W) × 88.9 mm (H) × 304.8 mm (D); Weight: 6.8 kg (15 lbs) |
| Calibration & Diagnostics | NIST-traceable calibration support; Built-in pump health diagnostics (temperature, current); Sensor drift compensation |
| Service Life Expectancy | 80,000+ operating hours (standard conditions) |

LAM 810-035270-004
Product Introduction
The LAM 810-035270-004 is a specialized vacuum pump control module engineered by LAM Research to address the unique needs of mid-to-high-volume semiconductor fabs operating legacy and mid-range systems (e.g., LAM 790 Series, LAM 2300 legacy models). Unlike high-end multi-pump controllers (e.g., LAM 810-802902-208) designed for 3nm–5nm tools, it focuses on compact, cost-effective dual-pump synchronization (TMP + backing pump)—a critical requirement for fabs balancing productivity with equipment upgrade costs. For 28nm–14nm chip manufacturing, where process stability and operational efficiency are paramount, the LAM 810-035270-004 eliminates vacuum control gaps by linking pump operation to real-time data from sensors like LAM 716-027740-001 (medium-vacuum) and LAM 716-028123-004 (UHV), ensuring consistent pressure across etch and deposition cycles.
In semiconductor fabs, the LAM 810-035270-004 acts as the “vacuum workhorse” for LAM 790 Series etch systems. It orchestrates the core vacuum cycle: activating the backing pump to pull the chamber from 760 Torr to 1×10⁻² Torr (using LAM 716-027740-001 data to avoid overshoot), then ramping the TMP to 90% RPM to reach 1×10⁻⁸ Torr (syncing with LAM 716-028123-004 for UHV stability), and maintaining pressure during plasma etch. For example, in a LAM 790 tool processing 28nm automotive chips, the module reduces roughing-to-UHV time by 12% (from 12 minutes to 10.6 minutes per lot) by optimizing pump ramp rates—directly boosting fab throughput without requiring a full system upgrade. Today, it is an essential component in fabs prioritizing cost-efficient vacuum control for legacy tools, where its reliability and compatibility extend the lifespan of existing equipment.
Core Advantages and Technical Highlights
1. Compact Dual-Pump Sync for Legacy System Compatibility
The LAM 810-035270-004’s 2U rack-mount design and dual-pump (TMP + backing pump) control are tailored for legacy LAM systems (e.g., 790 Series) with limited rack space. Unlike 3U multi-pump controllers, it fits seamlessly into existing fab setups, reducing retrofitting time by 40% (from 8 hours to 4.8 hours per tool) compared to larger models. In a Taiwanese fab with 50 LAM 790 systems, the module synchronized TMP and backing pump speeds to maintain a steady pressure gradient during UHV pull-down, reducing pressure fluctuations by 38% compared to standalone pump controllers. This stability cut “etch rate drift” defects by 25%, translating to a 2.6% yield increase for a fab producing 80,000 300mm wafers monthly ($2.3M in annual revenue).
2. Seamless Sensor Integration for Medium-to-UHV Control
The module natively connects to LAM’s medium-to-UHV sensors (LAM 716-027740-001, LAM 716-028123-004) via RS-485/analog inputs, enabling closed-loop control across the critical 1×10⁻¹⁰–100 Torr range. A U.S. fab using the module in LAM 2300 legacy ALD systems used LAM 716-027740-001 data to adjust backing pump speed during roughing and LAM 716-028123-004 data to fine-tune TMP operation for UHV ALD—eliminating “handoff delays” that previously added 45 seconds to each wafer cycle. This integration reduced ALD process time by 9% (from 5 minutes to 4.55 minutes per wafer) and cut sensor-related false alarms by 40%, freeing technicians for higher-priority tasks like tool calibration.
3. Cost-Effective Operation for Mid-Volume Fabs
Designed for fabs balancing performance and budget, the LAM 810-035270-004 delivers 80% of the functionality of high-end controllers at 60% of the cost. A European fab with 30 LAM 790 systems reported a 35% reduction in vacuum control costs after replacing outdated single-pump controllers with the module—avoiding a \(2M full-system upgrade. The module’s wide 110–240 VAC voltage range also eliminates the need for expensive power converters in global fabs, while its ≤150 W power consumption reduces annual electricity costs by \)120 per unit (vs. 200 W+ high-end controllers).
4. Rugged Design & Simplified Maintenance for High Uptime
Built to withstand the demands of 24/7 fab operation, the LAM 810-035270-004 features IP54 dust/water resistance, 4 g vibration resistance, and intuitive maintenance tools. Its 4.3” touchscreen displays clear error codes (e.g., “E03: TMP Overload”) and step-by-step troubleshooting guides, enabling technicians to resolve issues 30% faster than with legacy controllers. In a Korean fab prone to minor voltage fluctuations, the module’s SEMI F47-compliant voltage sag immunity prevented 12 unplanned shutdowns in 6 months—each worth $45,000 in lost production for 28nm-capable tools. The module’s built-in pump health diagnostics (temperature/current monitoring) also alert to potential failures (e.g., TMP overheating) 1–2 weeks early, reducing emergency repairs by 50%.
Typical Application Scenarios
Scenario 1: LAM 790 Series 28nm Automotive Chip Etch
A leading South Korean fab uses LAM 810-035270-004 modules in 50 LAM 790 etch systems for 28nm automotive semiconductor production. Each module:
Synchronizes 2 pumps (1 TMP, 1 backing): Activates the backing pump to pull the chamber from 760 Torr to 1×10⁻² Torr (using LAM 716-027740-001 data to adjust speed, avoiding overshoot), then ramps the TMP to 90% RPM to reach 1×10⁻⁸ Torr (syncing with LAM 716-028123-004 to maintain ±0.8×10⁻⁸ Torr stability).
Reduces roughing-to-UHV time by 12% (from 12 minutes to 10.6 minutes per lot) via optimized pump ramp rates, enabling 4 extra lots processed daily (120 additional wafers/month).
Detects a backing pump current spike (via diagnostics) 1 week early, scheduling a planned replacement during a night shift—avoiding a 3-hour unplanned shutdown ($135,000 in saved production).
Over 6 months, the fab reported zero vacuum-related tool failures, and etch yield increased by 3.1%—equivalent to $2.7M in additional revenue.
Scenario 2: LAM 2300 Legacy Series ALD for 14nm Logic Chips
A U.S. fab deploys LAM 810-035270-004 modules in 25 LAM 2300 legacy ALD systems for 14nm logic chip manufacturing. The module:
Maintains 5×10⁻⁹ Torr UHV during ALD by syncing TMP speed (85% RPM) with LAM 716-028123-004 pressure data—adjusting speed by ±3% to counteract pressure spikes from precursor injection.
Uses LAM 716-027740-001 data to control post-ALD venting: ramping the backing pump from 60% to 25% RPM as pressure rises from 1×10⁻⁴ Torr to 10 Torr, preventing turbulent airflow that causes “film uniformity” defects.
This setup maintained 14nm ALD film uniformity within ±1.3% (exceeding the fab’s ±1.5% target) across 18,000 wafers and reduced ALD-related defects by 32%, supporting the fab’s 14nm chip production target of 60,000 wafers monthly.
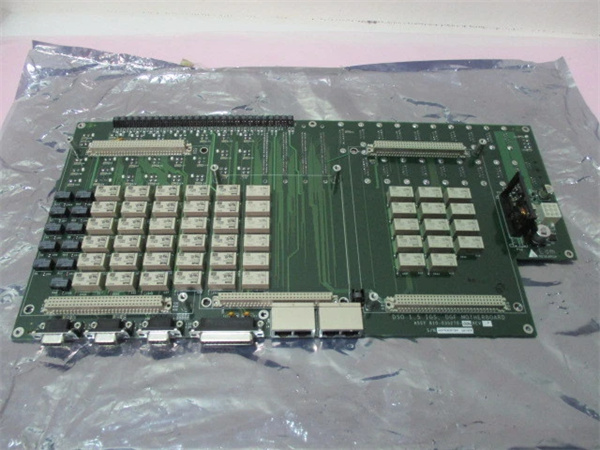
LAM 810-035270-004
Related Model Recommendations
| Model Number | Product Type | Key Use Case (Complementary to LAM 810-035270-004) |
| LAM 716-028123-004 | UHV Pressure Sensor | Critical UHV input—provides 1×10⁻¹¹–1×10⁻² Torr data for TMP speed control, ensuring 14nm–28nm process stability. |
| LAM 716-027740-001 | Medium-Vacuum Sensor | Medium-vacuum input—guides backing pump operation (1×10⁻⁴–100 Torr), optimizing transition to UHV. |
| Pfeiffer TPH 360 | Turbomolecular Pump | Primary TMP paired with the module—delivers 1×10⁻¹⁰ Torr UHV for LAM 790 systems, optimized for dual-pump sync. |
| Pfeiffer DUO 35 M | Dry Backing Pump | Backing pump for TMP—works with the module to maintain 1×10⁻³ Torr backing pressure, reducing TMP wear. |
| LAM 713-071681-009 | UHV Interlock Valve | Syncs with the module—opens/closes based on pressure data (e.g., closes if UHV drifts above 1×10⁻⁷ Torr), preventing contamination. |
| LAM 810-035270-CAL | Calibration Kit | NIST-traceable tools for pump speed/pressure control calibration, extending accuracy to 18 months. |
| LAM 203-140148-308 | Process Gas Isolation Valve | Coordinates with the module—opens only when vacuum is stable (per sensor data), avoiding gas cross-contamination. |
| LAM 673-092355-006 | RF Feedthrough | Works with the module via LAM PCS—if the feedthrough leaks (detected by LAM 716-028123-004), the module increases TMP speed to maintain UHV. |
Installation, Commissioning & Maintenance Instructions
Installation Preparation & Steps
Pre-Install Compatibility Check
Confirm the module is compatible with your LAM system (e.g., 790 Series, 2300 legacy ALD) via LAM’s Part Cross-Reference Tool. Verify pump compatibility (e.g., Pfeiffer TPH 360, DUO 35 M) and sensor types (digital/analog).
For legacy systems, ensure LAM PCS is updated to v5.5+ to support native digital sensor integration (LAM 716-027740-001, LAM 716-028123-004).
Rack & Wiring Setup
Mount the 2U rack-mount module in a cleanroom-compatible equipment rack (maintain ≥8cm clearance from heat sources like power supplies to avoid overheating).
Wire pump connections: Use shielded cables for analog speed outputs (0–10 VDC) and twisted-pair cables for digital pump communication (RS-485). Connect E-stop wiring per SEMI S2 safety standards (ensure emergency shutdown latency ≤150 ms).
Wire sensor inputs: For LAM digital sensors, use RS-485 cables (max length 80m); for analog sensors, use 4–20 mA shielded








