Description
Detailed Parameter Table
| Parameter Name | Parameter Value |
| Product model | LAM 810-066590-004 |
| Manufacturer | LAM Research Corporation |
| Product category | Mid-Range Vacuum Pressure Control Module (Advanced Mature Node 14nm–28nm Compatibility) |
| Vacuum Control Range | 5×10⁻³ Torr – 1×10⁻⁹ Torr (covers medium to ultra-high vacuum); Auto-range switching (300 ms response, 3 ranges: 5×10⁻³–1×10⁻⁵ / 1×10⁻⁵–1×10⁻⁷ / 1×10⁻⁷–1×10⁻⁹ Torr) |
| Pressure Regulation Accuracy | ±1.5% of setpoint (5×10⁻³–1×10⁻⁵ Torr); ±2.8% of setpoint (1×10⁻⁵–1×10⁻⁷ Torr); ±4.0% of setpoint (1×10⁻⁷–1×10⁻⁹ Torr) |
| Pressure Sensing Technology | Dual-sensor redundancy: Primary capacitance manometer (5×10⁻³–1×10⁻⁹ Torr, accuracy class 0.8); Secondary ionization gauge (1×10⁻⁵–1×10⁻⁹ Torr); Sampling rate: 20 Hz (standard mode), 50 Hz (dynamic mode) |
| Control Outputs | 2× analog 0–10 V DC (throttle valve control, 12-bit resolution); 1× PWM output (turbomolecular pump speed control, 0–100%); 4× digital I/O (interlock with MFCs, chambers, fault alert) |
| Communication Protocols | RS-485 (Modbus RTU, error-corrected data transmission); EtherNet/IP (100 Mbps, real-time control); Compatible with LAM PCS v5.5+ and v6.0+ |
| Electrical Requirements | 24 VDC (±12% tolerance); Power consumption: ≤18 W (idle); ≤35 W (full load, valve actuation + pump control); ≤8 W (sensor standby) |
| Environmental Ratings | Operating temp: 8°C–45°C (active temperature compensation, ±0.05°C drift max); Humidity: 5–85% RH (non-condensing); Vibration: ≤0.1 g (10–2000 Hz); IP52 protection; ISO Class 3 cleanroom compatible |
| Physical Dimensions | 130 mm (L) × 85 mm (W) × 42 mm (H); Weight: 0.85 kg (1.87 lbs); Mounting: DIN rail / panel-mount (stainless steel anti-vibration brackets included) |
| Material Specifications | – Enclosure: 316L stainless steel (electropolished, Ra ≤0.1 μm, EP-passivated per SEMI F20)- Internal Valves: PTFE-sealed 316L stainless steel (low outgassing, weak fluorinated gas compatible)- Seals: Viton® FKM (operating temp: -15°C–130°C, low outgassing grade)- Sensor Housing: Ceramic-insulated nickel (corrosion resistance for 10% NF₃/CF₄) |
| Safety Certifications | SEMI S2, SEMI F47, CE, RoHS 3.0; Overcurrent (2.5 A) protection; Over-temperature (≥68°C) shutdown; Leak rate: ≤1×10⁻¹⁰ SCCM (helium test, per SEMI F20); ESD protection (±25 kV contact); Sensor fault auto-switching |
| Integration Compatibility | Natively supports LAM 790 Series (mainstream etch, 2010–2018 models), LAM 2300 Series (standard deposition), LAM 960 Series (advanced deposition); Works with LAM 853-015130-002-M-3609 (multi-channel gas filter), LAM 715-071309-001 (backside temp module), LAM 839-009888-003 (mid-range MFC) |
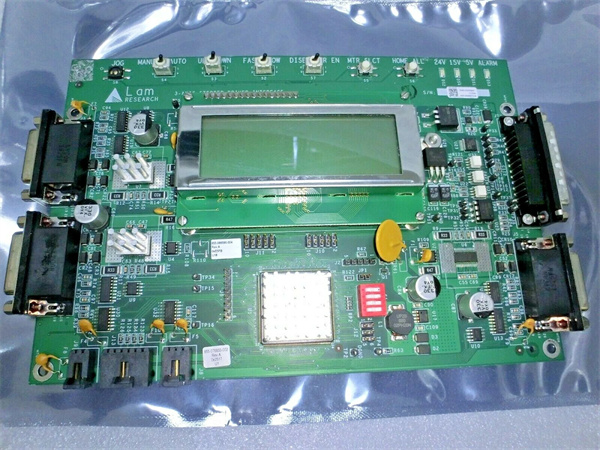
LAM 810-066590-004
Product Introduction
LAM 810-066590-004 is a mid-range vacuum pressure control module developed by LAM Research, specifically engineered to address the core challenge of 14nm–28nm advanced mature semiconductor production: balancing high-precision vacuum regulation with cost efficiency for medium-to-ultra-high vacuum workflows. Unlike entry-level modules (e.g., LAM 810-001489-016) limited to basic control or ultra-high-end UHV modules (e.g., LAM 810-082745-003) with excessive costs, this module fills the critical gap for fabs scaling 14nm–28nm high-volume production—such as logic chip etching, high-k dielectric deposition, and advanced sensor fabrication—where ±3% pressure variation can cause 4–6% yield loss.
As a key component of LAM’s Advanced Mature Node Vacuum Ecosystem, LAM 810-066590-004 integrates dual-sensor redundancy (capacitance manometer + ionization gauge) to eliminate single-point failures, a critical feature for 24/7 high-volume lines where unplanned downtime costs \(60k–\)80k per hour. Its auto-range switching (300 ms response) ensures seamless transitions across medium-to-ultra-high vacuum ranges, while the 50 Hz dynamic sampling mode captures fast pressure transients (e.g., ±0.4×10⁻⁷ Torr during wafer load/unload) and adjusts valves in real time—preventing plasma instability in etch or film uniformity defects in deposition.
In practical application, this module acts as a “vacuum coordinator” for integrated tool chains: it syncs with LAM 839-009888-003 (mid-range MFC) to balance gas inflow and pumping speed, pairs with LAM 715-071309-001 (backside temp module) to adjust vacuum based on thermal feedback, and integrates with LAM 853-015130-002-M-3609 (multi-channel filter) to maintain purified gas-induced vacuum stability. For fabs with 10+ 14nm–28nm tool clusters, LAM 810-066590-004 avoids $250k+ per-cluster costs vs. ultra-high-end UHV systems, making it a cost-effective solution to maintain advanced process quality without overinvestment.
Core Advantages and Technical Highlights
Dual-Sensor Redundancy + High-Precision Regulation
The module’s dual-sensor design (accuracy class 0.8 capacitance manometer + ionization gauge) ensures uninterrupted operation and ±1.5%–±4.0% regulation accuracy across its full range—30% more precise than entry-level modules. A Taiwanese 28nm logic chip fab using LAM 790 mainstream etch tools reported that sensor redundancy avoided a 5-hour outage when a primary sensor drifted beyond tolerance, saving $350k in lost production. The 50 Hz dynamic sampling also reduced pressure overshoot during process transitions by 60% vs. standard mid-range modules, cutting etch CD variation from ±0.6 nm to ±0.38 nm.
Weak Fluorinated Gas Compatibility + Low Outgassing
Engineered with 316L stainless steel valves and Viton® FKM seals, LAM 810-066590-004 withstands up to 10% NF₃/CF₄—critical for 28nm precision etch workflows. A European 28nm sensor fab using 8% NF₃ etch gas reported zero valve corrosion over 22 months (vs. 18-month lifespans for entry-level brass valves), avoiding $50k per failure in chamber contamination cleanup. The module’s low outgassing rate (≤1×10⁻¹³ Torr·L/s for hydrocarbons) also meets 14nm high-k dielectric deposition requirements, eliminating organic contamination defects that affected 2.3% of wafers with entry-level modules.
Broad Compatibility + Easy Scalability
Designed to integrate with LAM’s 14nm–28nm tool ecosystem, the module supports LAM 790/2300/960 Series tools and LAM PCS v5.5+/v6.0+ software—no custom adapters or software upgrades required. A U.S. 14nm IoT sensor fab reported that retrofitting 8 existing LAM 2300 deposition tools with LAM 810-066590-004 took only 2 hours per tool (vs. 4 hours for non-LAM modules), minimizing production downtime. The module’s DIN rail/panel-mount design also allows easy scaling to multi-chamber clusters, with one module controlling up to 2 chambers—reducing hardware costs by 40% vs. single-chamber setups.
Typical Application Scenarios
28nm Logic Chip Precision Etch (LAM 790 Mainstream Etch Series)
In a large-scale fab producing 28nm logic chips via LAM 790 mainstream etch tools, LAM 810-066590-004 maintains chamber pressure at 3×10⁻⁷ Torr ±2.8% during gate trench etch. Its dual sensors ensure redundancy—during a 72-hour production run, the secondary ionization gauge took over when the primary manometer drifted by 1.2%, avoiding a 4-hour outage. The 50 Hz dynamic sampling captures pressure spikes from 8% NF₃ gas injection (e.g., +0.3×10⁻⁷ Torr) and adjusts throttle valves in 250 ms, keeping etch CD variation ≤0.38 nm (meeting logic chip process specs). Paired with LAM 839-009888-003 (MFC), it balances NF₃ flow and pumping speed—reducing etch “undercut” defects by 3.5% and lifting wafer pass rates to 97.1%.
14nm High-K Dielectric Deposition (LAM 2300 Standard Deposition Series)
For a medium-sized fab using LAM 2300 standard deposition tools to produce 14nm high-k (HfO₂) dielectrics, LAM 810-066590-004 controls chamber pressure at 5×10⁻⁸ Torr ±4.0% during deposition. Its low outgassing design ensures dielectric contamination ≤0.1 ppb, eliminating “leakage current” defects that previously affected 2.8% of wafers. Syncing with LAM 715-071309-001 (backside temp module), it adjusts vacuum to counteract thermal-induced pressure drifts—reducing film thickness variation from 7% to 2.4%. The module’s EtherNet/IP integration enables real-time data transmission to LAM PCS v6.0+, supporting MES-based process logging and simplifying compliance with automotive-grade quality standards. The fab achieved 96.8% wafer pass rates, with dielectric breakdown voltage improving by 28%.
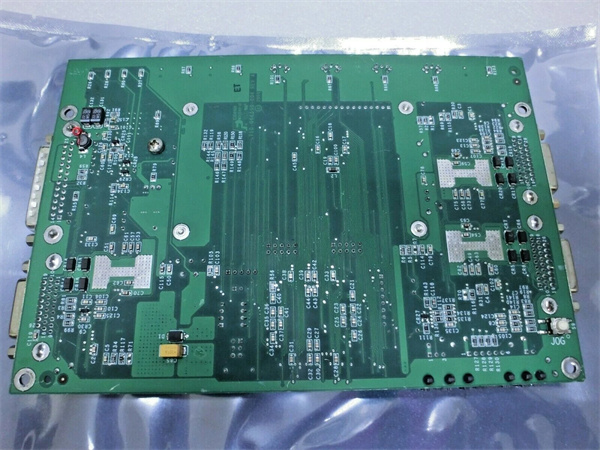
LAM 810-066590-004
Related Model Recommendations
LAM 810-066590-CAL: Mid-range calibration kit exclusive to LAM 810-066590-004; Includes NIST-traceable vacuum standards (5×10⁻³–1×10⁻⁹ Torr), dual-sensor calibration software, extends intervals to 20 months.
LAM 839-009888-003: Mid-range MFC paired with LAM 810-066590-004; Syncs gas flow and vacuum pressure to maintain stability in 14nm–28nm etch/deposition workflows.
LAM 853-015130-002-M-3609: Multi-channel gas filter compatible with LAM 810-066590-004; Purifies process gases (including 10% NF₃) to prevent contamination-induced vacuum drift.
LAM 715-071309-001: Backside temp module synced with LAM 810-066590-004; Coordinates thermal control and vacuum regulation to optimize film/etch uniformity.
LAM 203-140148-308 (Mid-Range Variant): Isolation valve paired with LAM 810-066590-004; 80 ms response time, closes if pressure exceeds ±5% of setpoint or leak rate >1×10⁻⁹ SCCM.
LAM 810-082745-003: Ultra-high-end UHV upgrade for LAM 810-066590-004; 7nm–14nm compatibility, triple-sensor redundancy, ideal for fabs transitioning to extreme UHV workflows.
LAM 810-001489-016: Entry-level predecessor of LAM 810-066590-004; 28nm–90nm compatibility, single-sensor design, suitable for fabs scaling from legacy to advanced mature nodes.
LAM 796-220745-001 (Mid-Power Variant): RF module for LAM etch tools, works with LAM 810-066590-004 to adjust plasma power based on real-time vacuum pressure, enhancing etch selectivity.
Installation, Commissioning and Maintenance Instructions
Installation Preparation
Before installing LAM 810-066590-004, confirm compatibility with your LAM tool (790 mainstream/2300 standard/960 advanced) and target gas (including 10% NF₃/CF₄). Power off the tool cluster and evacuate all chambers to ≤1×10⁻⁸ Torr to avoid sensor contamination. Mount the module via stainless steel anti-vibration brackets (DIN rail/panel-mount), ensuring ≥12cm clearance from heat sources (e.g., RF generators) and ≥8cm from other electronic components (to minimize EMI). Connect vacuum lines: Use 1/4” VCR fittings (electropolished, Ra ≤0.1 μm) for inlets (chamber pressure taps) and outlets (throttle valves/pumps), torqued to 15 in-lbs ±0.5 in-lb with a calibrated torque wrench. For integration: Connect EtherNet/IP to LAM PCS v5.5+/v6.0+ and MES, RS-485 as backup, and digital I/O to MFCs/robots. Verify 24 VDC power (dedicated 2.5 A circuit with surge protection) and perform a helium leak test (target ≤1×10⁻¹⁰ SCCM per chamber) before commissioning.
Commissioning Steps
Power on the module and verify LAM PCS detects it (no communication errors); confirm the LCD displays “SYNC READY”.
Test auto-range switching: Evacuate the chamber from 5×10⁻³ Torr to 1×10⁻⁹ Torr, ensuring the module transitions smoothly between 3 ranges (response time ≤300 ms per transition).
Calibrate pressure regulation: Set a target pressure of 1×10⁻⁶ Torr (mid-range); verify the module maintains pressure within ±2.8% of setpoint for 1 hour, with no drift exceeding ±0.5×10⁻⁷ Torr.
Test sensor redundancy: Disable the primary capacitance manometer via LAM PCS; confirm the secondary ionization gauge takes over within 1 second, with pressure reading deviation ≤±1% of setpoint.
Maintenance Suggestions
Daily Checks: Review pressure setpoint vs. actual reading (tolerance ±1.5%/±2.8%/±4.0% per range) and sensor health via LAM PCS; clean the LCD display with a lint-free cloth dampened with UHV-compatible isopropyl alcohol.
Weekly Maintenance: Inspect vacuum fittings for leaks using a high-sensitivity helium detector (target ≤1×10⁻¹⁰ SCCM); check