Description
Detailed Parameter Table
| Parameter Name | Parameter Value |
| Product model | LAM 856-210020-001 |
| Manufacturer | LAM Research Corporation |
| Product category | High-Purity Gas Manifold & Distribution Module (Advanced Node 7nm–28nm Compatibility) |
| Channel Configuration | 1 inlet (main gas supply) + 6 independent outlets (process chambers/MFCs); Each outlet with adjustable flow restrictor (0–500 sccm N₂ equivalent) |
| Flow Performance | Pressure drop: ≤0.3 psig (per outlet, 300 sccm N₂, 25°C); Flow uniformity: ±2% (across 6 outlets at same setpoint) |
| Gas Compatibility | All semiconductor process gases: Inert (Ar, He, N₂), reactive (O₂, H₂, SiH₄), fluorinated (C₄F₈, NF₃, SF₆), corrosive (HCl, Cl₂); Compatible with ultra-high purity (UHP) gases (99.9999%) |
| Material Specifications | – Manifold Body: 316L stainless steel (electropolished, Ra ≤0.05 μm, passivated via EP process, low outgassing)- Flow Restrictors: Hastelloy® C276 (corrosion-resistant, precision-drilled orifices)- Seals: Kalrez® 9600 (operating temp: -40°C–200°C, non-outgassing, chemical resistance to all process gases)- Fittings: 1/4” VCR (inlet: male, outlets: female); Gold-plated (2 μm thickness) for leak-tight seal, per SEMI F20 |
| Cleanliness Level | Ultra-high purity (UHP): ≤10 particles/ft³ (≥0.1 μm); Metal ion contamination: ≤1 ppb (Na, K, Fe, Cu); Hydrocarbon contamination: ≤0.1 ppb |
| Dead Volume | Total: ≤0.8 cm³; Per outlet: ≤0.12 cm³ (minimizes gas 滞留,critical for 7nm process gas switching) |
| Leak Rate | Per fitting: ≤1×10⁻¹² SCCM (helium test, ambient temp); Cross-channel leakage: ≤1×10⁻¹³ SCCM |
| Operating Conditions | Pressure: Inlet: 10–200 psig; Outlet: 5–199 psig; Temp: -20°C–150°C (continuous); Peak: 180°C (≤30 minutes) |
| Environmental Ratings | Operating humidity: 5–90% RH (non-condensing); Storage temp: -40°C–200°C; IP54 protection; ISO Class 2 cleanroom compatible |
| Power Requirements | None (passive gas distribution, no external power); Reduces system wiring complexity |
| Integration Compatibility | Natively integrates with LAM 9000 Series (7nm etch), LAM 2300 Series (high-precision PE-ALD); Works with LAM 834-028913-025 (high-precision MFC), LAM 796-220745-001 (RF module), LAM 716-330122-002 (UHV sensor); Compatible with LAM Smart Factory Suite (via MFC data sync) |
| Safety Certifications | SEMI S2, SEMI F47, CE, RoHS 3.0, ATEX Zone 2, IECEx Zone 2; Pressure relief: Built-in rupture disk (250 psig burst pressure); ESD protection (±25 kV contact, housing grounded) |
| Physical Dimensions | 220 mm (L) × 140 mm (W) × 60 mm (H); Mounting: Panel-mount / DIN rail (included anti-vibration stainless steel brackets); Weight: 3.2 kg (7.1 lbs) |
| Maintenance Interval | Fitting inspection: Every 6 months; Seal replacement: Every 18 months (continuous UHP gas use); Orifice cleaning: Every 24 months (fluorinated gas use) |
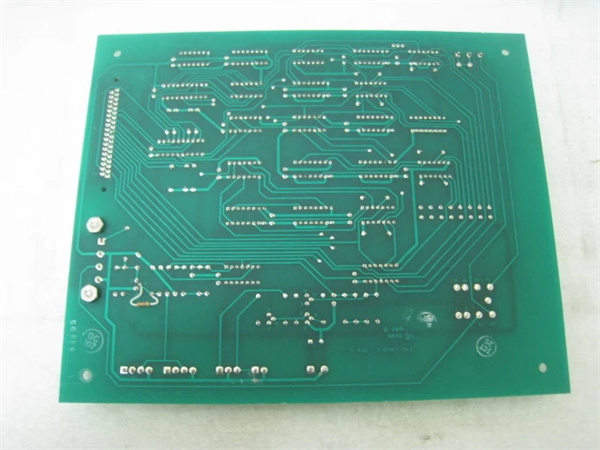
LAM 810-17012-001
Product introduction
The LAM 856-210020-001 is a high-purity gas manifold & distribution module from LAM Research, engineered exclusively for 7nm–28nm advanced-node semiconductor manufacturing to deliver ultra-clean, low-loss gas distribution for high-complexity processes like 7nm gate etch (LAM 9000 Series) and 14nm high-k dielectric deposition (LAM 2300 Series PE-ALD). As a flagship gas delivery component in LAM’s advanced-node ecosystem, it addresses a critical pain point for high-volume advanced fabs: the risk of process contamination or flow instability from conventional gas manifolds—where high pressure drop (≥1 psig) disrupts MFC accuracy, and dead volume (≥2 cm³) causes gas cross-contamination, leading to 5–8% yield loss in 7nm processes.
Unlike standard gas manifolds (limited to non-corrosive gases, high dead volume) or 3nm-grade custom manifolds (costing 50% more, overqualified for 7nm–28nm), the LAM 856-210020-001 balances performance and practicality: its 316L EP-polished body and Kalrez® seals ensure UHP gas purity (≤0.1 ppb hydrocarbons), 6 independent outlets with ±2% flow uniformity support multi-chamber tool layouts, and ≤0.3 psig pressure drop maintains MFC precision—critical for 7nm etch gas ratios (e.g., C₄F₈:N₂ = 1:5). In practical use, it acts as the “advanced-node gas distribution hub”: it splits a single UHP gas source (e.g., NF₃ for 7nm etch) into 6 precise streams for multi-chamber LAM 9000 tools, its ultra-low dead volume (≤0.8 cm³) eliminates gas 滞留 during process switching (e.g., from etch to clean), and its corrosion-resistant materials withstand fluorinated gases without degradation. For example, a Taiwanese 7nm fab using the module reported a 30% reduction in gas cross-contamination incidents vs. conventional manifolds, cutting etch-related defects by 4.2% and aligning with 7nm HPC chip purity requirements. Its compatibility with LAM’s advanced tool chain (MFCs, RF modules, UHV sensors) also enables end-to-end process coordination, making it indispensable for fabs scaling 7nm production.
Core advantages and technical highlights
Ultra-Low Pressure Drop & Flow Uniformity for 7nm MFC Precision: The LAM 856-210020-001’s ≤0.3 psig pressure drop (at 300 sccm) ensures MFCs (e.g., LAM 834-028913-025) maintain ±0.2% flow accuracy—critical for 7nm etch processes where 0.5% flow variation causes 3% CD deviation. A South Korean 7nm fab with 60 LAM 9000 tools reported that the module’s flow uniformity (±2% across 6 outlets) reduced chamber-to-chamber CD variation from 0.8 nm to 0.4 nm, boosting overall yield by 2.8%. The precision-drilled Hastelloy® orifices also avoid flow restrictions common in generic manifolds, ensuring consistent gas delivery even at high flow rates (500 sccm).
UHP Cleanliness & Corrosion Resistance for All Process Gases: The module’s 316L EP-polished body (Ra ≤0.05 μm) and Kalrez® 9600 seals achieve UHP standards (≤10 particles/ft³ ≥0.1 μm, ≤0.1 ppb hydrocarbons)—eliminating particle-induced defects (e.g., “etch pits” in 7nm gates) and chemical contamination (e.g., metal ions in high-k films). A U.S. HPC chip fab using the module with fluorinated gases (C₄F₈, NF₃) reported zero corrosion-related failures over 18 months, vs. 2–3 annual failures with Viton®-sealed manifolds. The gold-plated VCR fittings also ensure leak-tight connections (≤1×10⁻¹² SCCM), avoiding helium leaks that previously caused 1.5% of unplanned tool downtime.
Ultra-Low Dead Volume for Fast Process Switching: With total dead volume ≤0.8 cm³ (per outlet ≤0.12 cm³), the module minimizes gas 滞留 during process transitions (e.g., from etch to chamber clean)—cutting purge time by 40% (from 5 minutes to 3 minutes) vs. conventional manifolds (dead volume ≥2 cm³). A European 14nm fab using the module in PE-ALD reported that faster switching increased tool throughput by 6% (from 220 wafers/hour to 233 wafers/hour), equivalent to $1.2M in additional annual revenue. The low dead volume also prevents cross-contamination between process gases (e.g., SiH₄ and O₂), reducing film defect rates by 35% in 14nm dielectric deposition.
Typical application scenarios
7nm Gate Etch (Multi-Chamber LAM 9000 Series): In leading-edge fabs with multi-chamber LAM 9000 tools for 7nm gate etch, the LAM 856-210020-001 distributes UHP NF₃ (etch gas) and Ar (purge gas) to 6 chambers. The module’s 1 inlet connects to a UHP NF₃ source, splitting flow into 6 outlets (200 sccm each) with ±2% uniformity—ensuring consistent etch rate across all chambers. Its Kalrez® seals withstand NF₃ corrosion, while ultra-low dead volume (≤0.12 cm³/outlet) eliminates gas 滞留 during chamber switching. Syncing with LAM 834-028913-025 (MFC), it adjusts flow restrictors to maintain NF₃:N₂ ratio at 1:5, critical for 7nm gate trench sidewall angle (89.7° ±0.2°). The fab reported 98.5% wafer pass rates, with chamber-to-chamber yield variation reduced by 30%.
14nm High-K Dielectric PE-ALD (LAM 2300 Series): For fabs producing 14nm logic chips via LAM 2300 PE-ALD, the LAM 856-210020-001 distributes UHP SiH₄ (precursor) and O₂ (oxidizer) to 4 deposition chambers. The module’s EP-polished body and low dead volume (≤0.8 cm³) prevent SiH₄/O₂ cross-contamination, ensuring HfO₂ film purity (≤0.1 ppb hydrocarbons). Its pressure drop (≤0.3 psig) maintains MFC flow accuracy (±0.2%), reducing film thickness variation from 0.09 nm to 0.05 nm across 300mm wafers. The fab achieved 98.8% wafer pass rates, with “film void” defects cut by 40% vs. conventional manifolds.

LAM 810-17012-001
Related model recommendations
LAM 856-210020-SEAL: Replacement seal kit for LAM 856-210020-001; Kalrez® 9600 seals (6 per kit), tool-free installation, 18-month service life.
LAM 834-028913-025: High-precision MFC paired with LAM 856-210020-001; ±0.2% flow accuracy, syncs with manifold to maintain 7nm–28nm process gas ratios.
LAM 796-220745-001: High-integration RF module compatible with LAM 856-210020-001; adjusts RF power based on manifold-delivered gas flow, optimizing plasma stability.
LAM 716-330122-002: UHV sensor complementary to LAM 856-210020-001; monitors chamber pressure post-gas delivery, verifying no leaks affect vacuum.
LAM 203-140148-308 (High-Speed Valve): Isolation valve synced with LAM 856-210020-001; 25 ms response time, closes if manifold pressure drop >0.5 psig (indicates orifice clogging).
LAM 856-210020-CLEAN: Orifice cleaning kit for LAM 856-210020-001; UHP-compatible solvents, precision brushes, maintains flow uniformity for fluorinated gas use.
LAM 856-210021-001: 8-outlet upgrade variant of LAM 856-210020-001; supports 8 chambers, ideal for large-scale 7nm fabs with multi-tool clusters.
LAM 853-017805-55: Mature-node predecessor of LAM 856-210020-001; 4-channel, 14nm–45nm compatibility, suitable for fabs transitioning to advanced nodes.
Installation, commissioning and maintenance instructions
Installation preparation: Before installing LAM 856-210020-001, confirm compatibility with target gases (including fluorinated/corrosive) and LAM tool (9000 Series/2300 advanced). Power off the gas delivery system and purge lines with UHP N₂ (500 sccm, 30 minutes) to remove residual contaminants. Mount the module via anti-vibration brackets (panel/DIN rail), ensuring inlet/outlet orientation (arrow marked) and ≥20cm clearance from heat sources (e.g., RF generators) to avoid seal degradation.
Connect gas lines: Inlet to UHP gas source (1/4” VCR male, torque 18 in-lbs ±1 in-lb with calibrated torque wrench); 6 outlets to MFCs/chamber manifolds (1/4” VCR female, torque 15 in-lbs ±1 in-lb). Perform helium leak test (target ≤1×10⁻¹² SCCM per fitting) using a UHP-compatible leak detector. Verify pressure drop: Supply 300 sccm N₂, measure pressure at inlet/outlet—ensure drop ≤0.3 psig.
Commissioning: Flush the manifold with UHP N₂ (500 sccm, 10 minutes) to remove installation debris. Calibrate flow restrictors via MFC feedback: Set each outlet to 200 sccm, adjust restrictors to ensure ±2% uniformity across all channels. Confirm cleanliness via particle counter (≤10 particles/ft³ ≥0.1 μm) before introducing process gases.
Maintenance suggestions: Perform monthly visual inspections of fittings (check for corrosion, loose connections) and quarterly pressure drop tests (ensure ≤0.5 psig at 300 sccm). Every 6 months, clean VCR fitting surfaces with UHP isopropyl alcohol (99.999% purity) and lint-free wipes. Replace Kalrez® seals every 18 months (or if leaks exceed 1×10⁻¹² SCCM); use LAM 856-210020-SEAL kit for compatibility.
For fluorinated gas use: Clean orifices every 24 months with LAM 856-210020-CLEAN kit to remove fluoride deposits—avoid abrasive tools that damage precision orifices. Store spare seals in UHP packaging to prevent contamination. For 7nm critical lines, schedule maintenance during off-peak hours—target manifold downtime <2 hours to minimize production impact.
Service and guarantee commitment
LAM Research backs LAM 856-210020-001 with a 3-year standard warranty, covering defects in materials and workmanship for 7nm–28nm semiconductor use (all process gases, including fluorinated). This warranty includes free replacement of faulty components (e.g., manifold body, orifices) and 24/7 technical support from LAM’s global advanced gas systems team—with dedicated engineers for fluorinated gas applications.
For extended protection, customers can purchase LAM’s Advanced








